
扫码体验VIP

扫码VIP小程序
玻璃基板封装:玻璃基板封装板块是指在股市中,涉及玻璃基板封装技术的相关企业和概念的集合。这一板块随着半导体封装领域的技术进步而逐渐受到市场关注。
- 板块介绍
- 板块百科
- 板块资讯
- 强势股票
玻璃基板封装:英伟达GB200将采用玻璃基板
1、板块介绍
全球半导体巨头纷纷布局玻璃基板封装技术。英特尔推出了业界首款用于下一代先进封装的玻璃基板,计划于 2026 年至 2030 年实现量产,并投资 10 亿美元在亚利桑那州建立玻璃基板研发中心。三星组建了新的跨部门联盟,着手联合研发玻璃基板,计划 2026 年实现量产,其世宗试验线已实现 TGV 深宽比 10:1 的突破,铜填充空洞率 < 0.5%。
2、玻璃基板优势
电气性能优越:玻璃是绝缘材料,相对介电常数低,约为硅片的三分之一,寄生电容小,可减少信号传输损失,在高速传输中能提供更好的功率效率和信号完整性。同时玻璃电阻率高,相邻互连间电流泄漏小,串扰或噪声问题比硅材料小,有利于保障互联密度和信号完整性,满足人工智能芯片等高性能芯片封装需求。
热稳定性良好:玻璃基板热膨胀系数为 3-9ppm/K,与硅的 2.9 - 4ppm/K 接近,在芯片封装过程中,不易因产生热量导致各层材料间形变程度不同而发生翘曲。其杨氏模量为 50 - 90GPA,高于有机材料,抵抗形变能力更强,能有效对抗封装过程中的翘曲问题,适合大尺寸封装。
化学稳定性强:玻璃基板化学稳定性出色,吸湿性比有机材料低,能有效抵抗湿气、酸碱等环境侵蚀,可保障封装内元件的长期稳定性。
平整度高:具有较高的表面平整度和低粗糙度,为微小尺寸半导体器件的制造提供了理想平台,有利于高密度的再分布层(RDL)布线,可实现更高的互连密度。
传统与先进封装的一个主要差异在于与外界的连接方式,DIP类通过引线框架分布在两侧的引脚;QFN类无引脚,通过四侧的扁平电极触点连接;其他高端先进封装则通过封装基板上的焊球等材料互连,连接点可布满整个底面。考虑封装技术的发展趋势,
以是否使用引线框架来区分传统封装与先进封装,将使用引线框架的归类为传统封装。
3、市场空间
玻璃基板有望成为下一代封装基板,预计2030年前实现量产。玻璃基板(GCS)在成本、性能方面具备诸多优势,包括:大尺寸超薄面板玻璃易于获取;板级封装比晶圆级封装能一次封装更多芯片,也能避免边缘材料的损失;平整的表面支持更精细的RDL;优良的电学性能支持高速传输,也能减少损耗;与硅相近的热膨胀系数可减轻翘曲带来的困扰等。
玻璃基板的优势契合当前高性能计算等技术的发展需求,英特尔认为玻璃基板有望成为下一代封装基板,有望在2030年前实现量产,但长期看会与有机基板共存。玻璃基板目前仍然面临许多难题,产业链正协同发力,共同推进玻璃基板加速落地。预计玻璃基板2029年市场规模约2.12亿美元,并有望在2035年达到60亿美元。玻璃基板目前处于前期技术导入阶段,短期市场规模存在较大不确定性。为初步估测玻璃基板可能的市场空间,假设玻璃基板市场规模有望在2030年左右实现快速增长,渗透率在2040年达到35%。基于上述重点假设及其他假设条件,预计半导体封装用玻璃基板的渗透率有望在2035年达到20%,市场规模有望达到60亿美元,长期市场空间较大。
玻璃基板封装概念解析与市场展望
股市中的新热点与技术前沿
股票相关名词解释
玻璃基板封装板块:指股市中专注于玻璃基板封装技术的公司及其相关概念的集合。这些公司通常在半导体封装、显示面板制造等领域有着显著的技术实力和市场布局。
什么是玻璃基板封装
技术背景
玻璃基板封装技术是近年来半导体封装领域的一项重要进展。它采用玻璃基载板替代传统载板进行芯片封装,为高性能计算、数据中心、人工智能(AI)以及图形处理应用等领域带来了显著的优势。
技术特点
- 高密度互连与高速传输:玻璃基板具有更高的互连密度和更高效的输入/输出能力,支持更快的信号传输速度和更低的功耗。
- 耐高温与稳定性:玻璃基板在封装过程中展现出卓越的耐高温性,能有效减少翘曲和变形,使封装和光刻更为简便。
- 可调节强度与低能耗:相较于传统的PCB基板,玻璃基板在降低能耗的同时,还能提供可调节的强度,满足多样化的应用需求。
市场应用
玻璃基板封装技术已广泛应用于高性能计算芯片、显示面板等领域。随着英伟达等科技巨头在供应链中采用先进的封装工艺,玻璃基板的市场需求进一步增长。预计未来几年,基于玻璃基板技术的下一代先进封装TGV技术有望迎来爆发式增长。
相关企业
在股市中,涉及玻璃基板封装技术的公司众多,如沃格光电、雷曼光电、三超新材等。这些公司在玻璃基板的技术研发、生产制造以及市场拓展方面取得了显著成果。
总结
玻璃基板封装技术作为半导体封装领域的新热点,凭借其高密度互连、高速传输、耐高温与稳定性等技术优势,在高性能计算、显示面板等领域展现出广阔的市场前景。相关企业也在不断推进技术创新和市场拓展,为投资者带来了新的投资机会。
以上内容详细解析了玻璃基板封装技术在股市中的表现及其技术背景、特点、市场应用等相关信息,为投资者提供了全面的参考。
2026-05-13 14:42
玻璃基板:SKC豪掷53亿押注玻璃基板,台积电CoPoS中试线6月完工,下一代封装材料卡位战打响,这家公司手握TGV激光微孔设备或受益增量需求
SKC宣布融资53亿元押注玻璃基板,台积电CoPoS中试线预计6月完工、2028年前后量产,英特尔、苹果同步加码布局。玻璃基板凭借低热膨胀系数、低介电损耗等优势,有望成为下一代先进封装核心材料,产业链多个环节迎来增量机遇。
2026-05-13 09:43
玻璃基板概念异动拉升,彩虹股份涨停,新益昌涨超10%,沃格光电、壹石通、凯盛科技、安彩高科、五方光电跟涨
2026-05-11 18:57
沃格光电:公司关注到近期市场对玻璃基在半导体先进封装领域应用的关注度较高。目前,公司在泛半导体领域的业务尚处于早期阶段,相关产品技术仍处于研发验证或送样验证阶段,尚未形成规模化工业量产,营收规模占比极低,且相关经营主体目前仍处于亏损状态。该业务的产业化进程、未来订单规模及经营效益存在较大不确定性
2026-05-07 20:52
CoWoS之后,下一代先进封装会是CoPoS?
华泰证券报告表示,随着AI芯片面积持续扩大,传统CoWoS封装已接近物理极限。以台积电为代表的龙头厂商正加速推动CoPoS技术——用方形玻璃基板替代圆形硅中介层。玻璃基板尺寸更大、信号损耗更低、不易翘曲。台积电已启动试产线,大规模量产预计2028年,产业链迁移已实质性启动。
2026-05-07 09:51
玻璃基板概念震荡走强,彩虹股份封涨停,帝尔激光、天承科技、阿石创、凯盛科技、五方光电涨幅居前
2026-04-21 10:44
如何看待玻璃基封装载板的前景和壁垒?
2026-04-20 18:22
沃格光电:公司关注到近期市场对玻璃基在半导体先进封装领域的应用高度关注。目前公司玻璃基半导体先进封装业务尚处于送样验证阶段,占公司营业收入比重极低,处于亏损状态。新业务的产业化进程、未来订单规模存在较大不确定性
2026-04-17 15:19
一图了解玻璃基板概念股
2026-04-17 13:48
台积电先进封装路线图生变:CoWoS“生命周期更长”,下一代CoPoS“最快也要2030年4季度”
台积电先进封装路线图生变:CoPoS量产时程大幅延后至2030年第四季,较市场预期推迟约两年,技术瓶颈"均匀度"与"翘曲"难题是主因。与此同时,CoWoS未来两年产能已被英伟达等客户订满,SoIC更计划2027年扩产至月产5万片。
2026-04-17 12:13
AI芯片封装的下一个关键技术,台积电加码玻璃基板,一图了解相关概念股
玻璃基板的核心优势在于:热稳定性极佳,不易翘曲;表面超光滑,比有机材料光滑约5000倍,可支持更精密的线路布局;同时可引导光信号,为芯片间光互联奠定基础。玻璃基板能将连接密度提升10倍、同时降低能耗,使同等面积内封装更多芯片成为可能。
2026-04-15 10:37
玻璃基板封装概念表现活跃,沃格光电5天3板,股价创历史新高,天承科技涨超10%,彩虹股份、壹石通、光力科技、隆利科技涨幅靠前
2026-04-09 10:04
玻璃基板封装概念持续走强,沃格光电拉升封板,五方光电、彩虹股份此前涨停,帝尔激光、蓝特光学、美迪凯涨超5%
2026-04-09 07:13
苹果启动AI服务器玻璃基板测试,行业今年有望小批量商业化
苹果启动代号"Baltra"AI服务器芯片的玻璃基板测试,直接向三星电机采购T-glass样品,目标2027年后量产。玻璃基板凭借更低信号损耗、高尺寸稳定性等优势,正加速替代传统有机基板,2026年有望实现小批量商业化出货,全球市场规模预计从2024年70.1亿美元增长至2032年123.3亿美元。今日重要性:✨
2026-02-03 14:46
玻璃基板:量产节点确定,三星加速推进半导体玻璃基板商业化,A股这只弹性标的已着手研发,还与多家光模块、光芯片客户形成订单
三星电机推进半导体玻璃基板商用化,预计2027年后量产。该产品适配AI芯片、先进封装等场景,市场空间广阔。机构认为,其商业化将带动行业发展,国内企业有望依托技术突破把握国产化机遇,上游材料与中游工艺是核心突破点。
2025-09-30 07:36
提升芯片+数据中心性能,苹果、特斯拉被爆引入玻璃基板封装
厚度比PCB更薄、更平坦,可以实现微型电路。今日重要性:✨
| ID | 股票名称 | 涨幅% | 现价 | 换手率% | 总市值 | 炒作逻辑 |
|---|---|---|---|---|---|---|
| 1 | 彩虹股份 | 10% | 10.45 | 2.94% | 375亿 | 公司收到美国国际贸易委员会(ITC)公布337-TA-1441案件初裁结果,认定现用自主研发的“616”新料方玻璃基板不侵犯美国康宁公司专利 |
-
VIP复盘工具
- 更多复盘工具
- 股票复盘百科
-
股票复盘知识
- 短线交易攻略:超短策略深度解析
- 中国股民必须领悟的股市智慧
- 揭秘股神绝技:集合竞价选股策略深度剖析
- 深耕一股,稳健盈利——炒股做精一只股的策略分析
- 个股闪崩频发:市场警钟长鸣,投资者如何应对?
- 精准捕捉主升浪:选股策略与风险控制指南
- 识别陷阱:深度剖析垃圾股的八大警示信号
- 揭秘股市中的“最强板”现象:策略与逻辑的深度剖析
- 股市江湖:揭秘炒股四大门派与财富之道
- 开盘操作股票的八大实战技巧深度解析
- 可转债投资全攻略:解锁财富增长新路径
- 散户炒股的智慧之道:探索高效策略与稳健心态
- 揭秘龙回头二波行情的高胜率策略
- 股市盈利者的奥秘:探寻成功交易者的特质与策略
- 波浪理论深度解析:揭秘三浪与五浪的市场奥秘
- 剖析股市整体行情转弱的四大标志
- 炒股的艺术:心理素质的较量
- 股市智者:成功投资人的多维度剖析
- 股市策略深度解析:洗盘的艺术与目的
- 半路板交易的深度剖析与策略构建
当前版本:V3.0
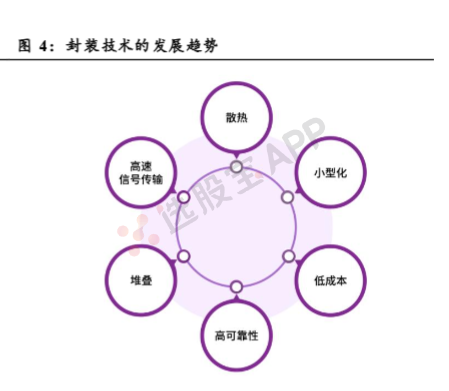
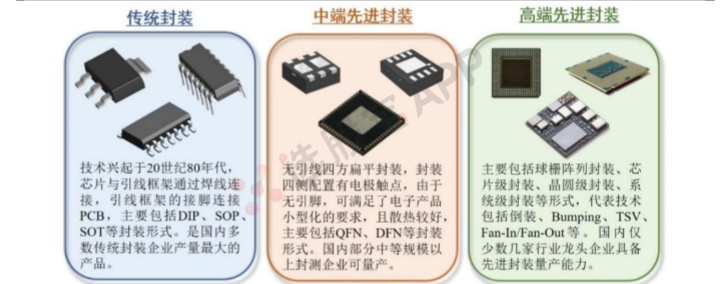

 VIP复盘网
VIP复盘网
