
当前以谷歌为代表的ASIC TPU方案崛起,加速全球算力芯片格局变化。
下一阶段AI芯片的比拼不仅是关于架构,更有可能是关于先进的封装能力。
在AI强劲需求的大背景下,CoWoS封装面临产能短缺、光罩尺寸限制以及价格高昂等问题。
在此背景下,已有云巨头开始考虑从台积电的CoWoS方案,转向英特尔的EMIB技术。
据Trendforce最新观察,谷歌下一代TPU(v8或v9),甚至微软未来的ASIC,可能会将部分CoWoS封装业务转移给英特尔,因其有良率和成本等优势且愿扩大生产规模。
先进封装技术是算力芯片发展的重要趋势,也是解决芯片封装小型化和实现高密度集成这两大难题的关键途径。
当前先进封装正在同步开启转型的步伐,面向云规模的EMIB部署最早或于2026至2027年出现。
本文重点梳理先进封装产业链以及EMIB核心环节。
01
先进封装行业概览
封装是芯片制造的关键环节。
每一代封装技术演进的本质是为了实现更高密度的集成、减小面积浪费以及提高元器件反应速度。
传统封装由于自身局限难以满足算力芯片的高标准,在此背景下先进封装技术应运而生。
先进封装技术通过将多个芯片或芯片模块进行高密度集成,在不突破制程极限的前提下,实现芯片性能的提升和小型化。
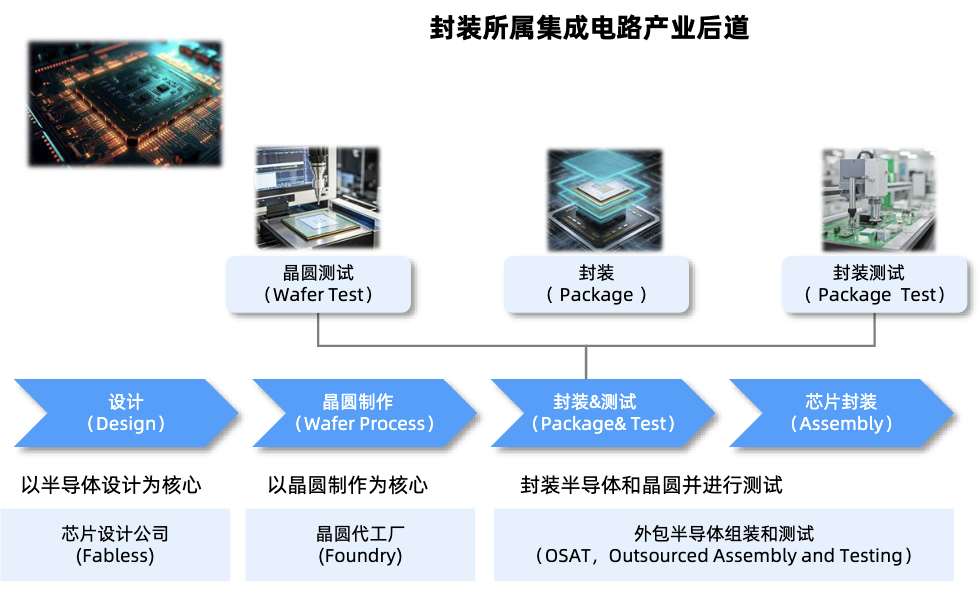
资料来源:行行查
先进与传统封装的区别
传统封装主要采用引线键合工艺实现芯片与外部系统的电连接;先进封装省略了引线方式,采取传输速度更快的凸块中间层等实现电连接。
传统封装形态上主要是2D平面结构,芯片之间缺乏高速互联的硬件支持;先进封装能够支持多芯异构集成,具有2.5D/3D结构,且芯片之间能实现高速互联。

当前先进封装主要包括倒装(Flip Chip)、凸块(Bumping)、晶圆级封装(WLP)、系统级封装(SIP)、2.5D 封装(interposer,RDL等)、3D封装(TSV)等封装技术。
其中,2.5D和3D封装是AI芯片核心方案。
2.5D封装:介于2D和3D封装之间的技术,将处理器、存储等若干芯片并列排布在中介层上,利用RDL、硅桥、硅通孔(TSV)等技术实现更高密度的互联。采用台积电CoWoS封装形式的英伟达GPU芯片是2.5D封装技术的典型代表,已经实现大规模量产。
3D封装:将多个芯片垂直堆叠,通过硅通孔(TSV)实现芯片之间的电气连接。这种封装方式能够进一步提高芯片的集成度和性能,但技术难度也相对较高,目前可用于DDR、HBM等存储芯片封装中。
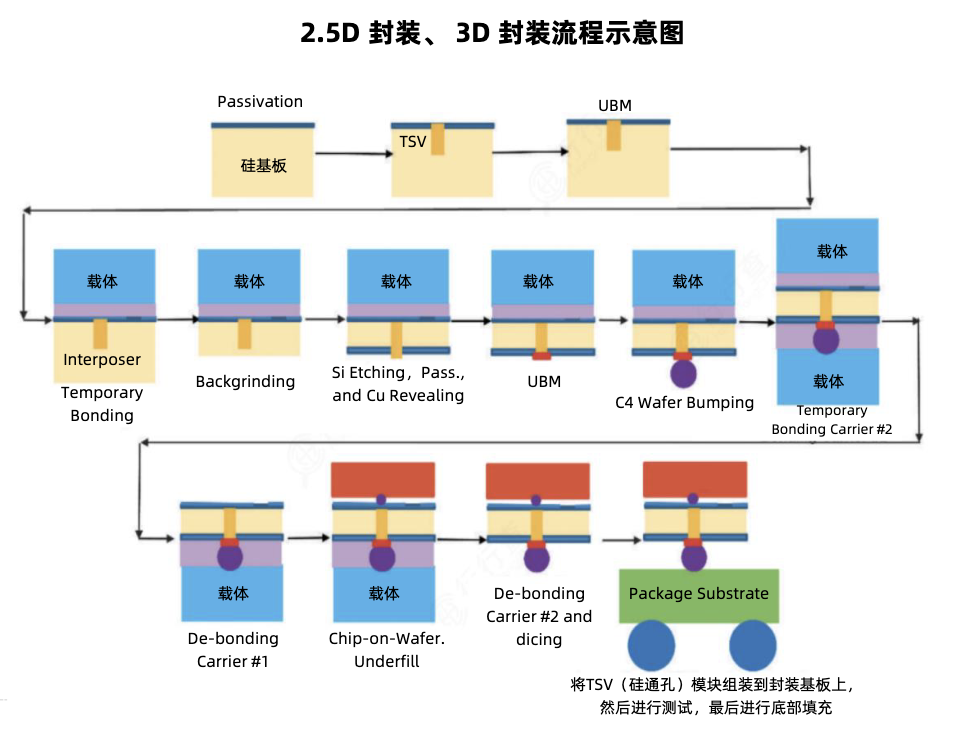
02
什么是EMIB?
EMIB(嵌入式多芯片互连桥接)是英特尔提出的一种2.5D先进封装技术。
通过嵌入基板内部的微型硅桥实现芯片间的高密度互连,在异构集成、成本效益和设计灵活性方面具有显著优势,尤其适合对成本敏感、需快速迭代的高性能计算和AI芯片市场。
EMIB技术已量产近十年,主要应用于英特尔自家ServerCPU及数据中心GPUMax系列。
EMIB与CoWoS的区别
CoWoS以“全硅中介层”实现极致带宽,主导AIGPU市场;EMIB以“微型硅桥”平衡成本与性能,抢占ASIC与定制化芯片市场。
CoWoS的中介层成本随尺寸指数级增长(如CoWoS-S5中介层面积达2400mm²),而EMIB通过硅桥复用设计,成本增长更平缓。
CoWoS目标客户英伟达和AMD等GPU供应商,需极致带宽支持大规模并行计算(如深度学习训练)。EMIB的目标客户,如谷歌、Meta等自研ASIC的云端服务商,需灵活集成不同工艺节点芯片。

EMIB技术优势和迭代
封装尺寸扩展:EMIB-M已支持6倍光罩尺寸,预计2026-2027年扩展至8-12倍,满足AI芯片对更大封装面积的需求。
降低成本:EMIB技术摒弃了传统2.5D封装中使用的硅中介层,转而采用嵌入基板内部的微型硅桥,进行芯片间互连。因此简化了整体结构,降低了封装成本。
高良率:与传统的2.5D封装相比,EMIB减少了复杂的工艺步骤,如“芯片对晶圆”(Chip-on-Wafer)流程,从而提高了生产稳定性和良率。
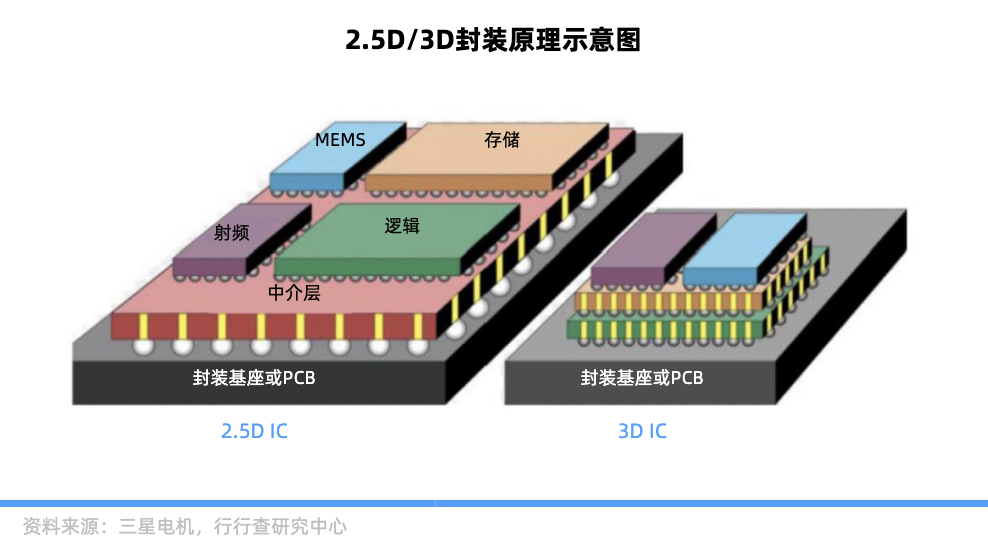
性能升级:最新EMIB-T技术引入TSV通孔供电,信号传输速度达32Gb/s,兼容UCIe2.0协议,支持HBM4集成,进一步缩小与CoWoS的带宽差距。
设计灵活性:EMIB技术允许在同一封装内放置异质芯片和混合元件,以满足系统/产品性能要求。其支持不同工艺节点、不同功能的芯片IP灵活组合,类似于一个松散的SoC(系统级芯片)。

资料来源:行行查
技术迭代:英特尔在EMIB技术上持续投入研发。例如,第一代EMIB实现了55微米的凸块间距,而第二代EMIB则缩小至45微米间距。英特尔表示将很快支持35微米间距,25微米间距的间距也在开发中。
英特尔通过结合Foveros2.5D与EMIB,综合产能超行业水平两倍,吸引AWS、Cisco等客户采用其先进封装技术。
此外,谷歌计划在2027年TPUv9中导入EMIB,Meta评估用于MTIA产品。
不过,EMIB技术受限于硅桥面积与布线密度,可提供的互连带宽相对较低、讯号传输距离较长,并有延迟性略高的问题。因此目前仅ASIC客户较积极在评估洽谈导入。
随着AI芯片需求爆发,EMIB与CoWoS的竞争将推动先进封装技术向更高密度、更低成本、更灵活的方向演进,成为后摩尔时代芯片性能提升的关键引擎。

资料来源:行行查
03
先进封装产业链
先进封装产业链包括上游原材料及设备、中游封装和测试以及下游应用。
上游原材料和设备:主要封装材料有基板、引线框架等,以及光K机、蚀刻机等封装设备。半导体九大核心设备全解析、半导体八大核心材料解析
中游封装和测试:芯片的先进封装和测试,采用倒装芯片、晶圆级封装、系统级封装等先进技术。测试服务包括对封装后的芯片进行电性测试、老化测试等,确保芯片的质量和可靠性。
下游应用领域:覆盖AI高算力芯片、消费电子、汽车电子、半导体器件和通信等多个领域。
先进封装产业链图示:

先进封装材料
先进封装相对传统的变化主要在于对减薄/抛光要求提高和新增RDL、Bumping、TSV环节,主要包括电镀液、临时键合胶、PSPI等。
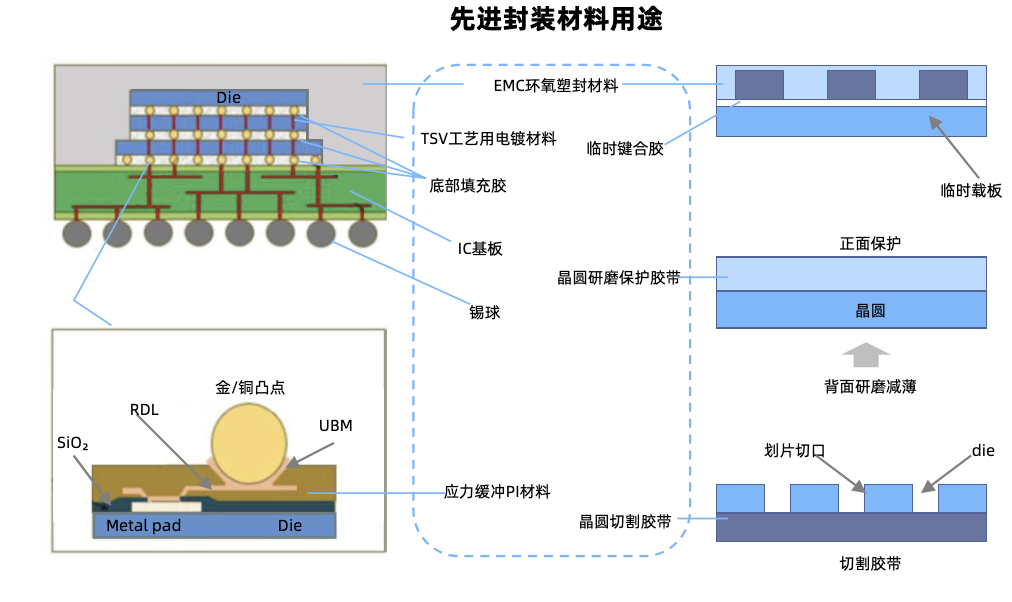
电镀液:电镀工艺在先进封装中广泛应用,电镀液是核心原材料,用于TSV、RDL、Bumping及混合键合等工艺中的金属化薄膜沉积。国内主要布局厂商包括强力新材,艾森股份,天承科技,上海新阳等。
临时键合胶:特殊胶粘材料,用于将超薄晶圆临时固定在刚性载片上。国内厂商飞凯材料打破3M垄断,鼎龙股份已突破临时键合胶耐高温、低挥发份等关键技术。
PSPI光刻胶:作为先进封装的核心耗材,主要应用于再布线(RDL)工艺,能够显著简化光刻工艺流程,有望全面取代传统光刻胶。强力新材、波米科技、艾森股份、飞凯材料等在该领域有所布局。
环氧塑封料:应用最广泛的包封材料,为芯片提供防护导热和支撑等核心功能。华海诚科布局环氧塑封料和底填胶、联瑞新材突破电子级球型硅微粉技术垄断、壹石通在Low-α球硅与球铝领域有所布局。
封装基板:先进封装的关键材料,为芯片提供电连接、保护支撑、散热等功效。ABF基板适合高密度布线和高传输速率的集成电路,用于高性能计算芯片封装,国内兴森科技、深南电路等厂商在该领域加速布局。玻璃基板有望成为下一代先进封装基板的关键材料,沃格光电是全球少数同时掌握TGV技术的厂家之一。
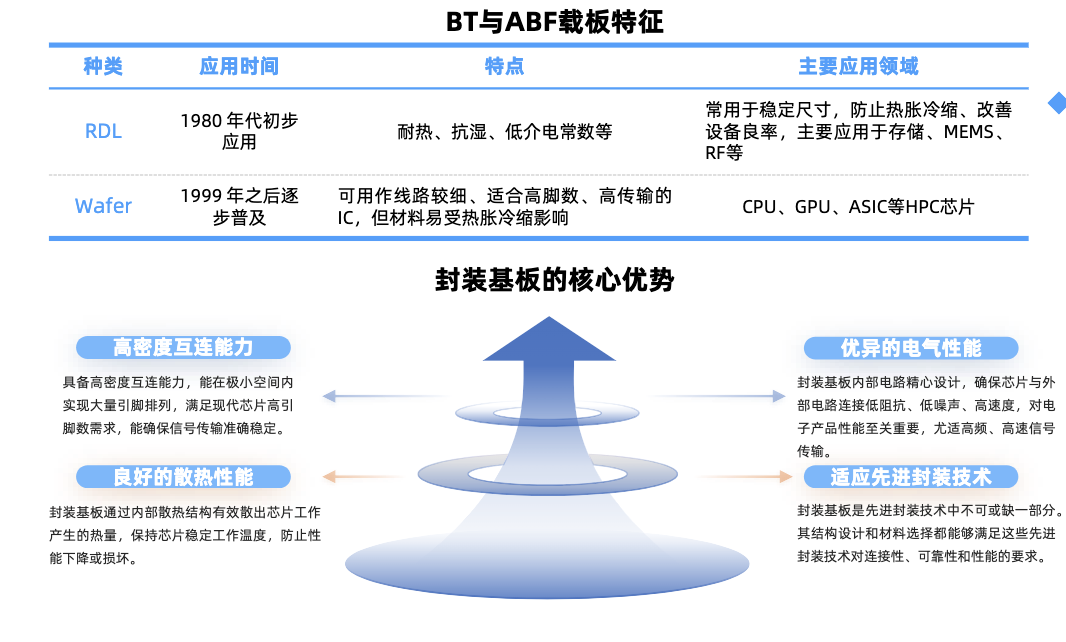
先进封装设备
在先进封装技术领域,核心设备是实现高性能和小型化封装的关键要素。
COW倒装固晶、CMP(化学机械抛光)、电镀、临时键合与解键合、量检测、光刻和刻蚀等环节构成先进封装的核心工艺流程。
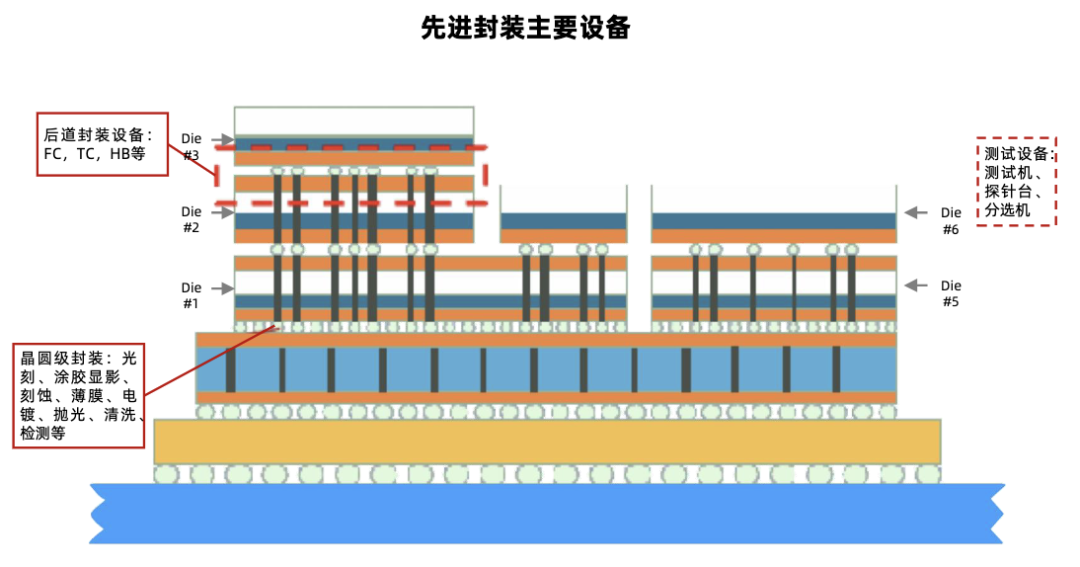
AI芯片和HBM 内存制造需求攀升,推动先进封装设备市场快速增长。
而先进封装装备技术快速升级,以及前道工艺后移,进一步推动刻蚀/薄膜沉积/电镀等设备需求增量。
前道设备:(如光K机、刻蚀机、薄膜沉积设备等)与先进封装设备在核心技术上存在重叠,可直接应用于先进封装领域,降低研发门槛。

资料来源:行行查
国产前道设备厂商向先进封装领域布局在一定程度上可视为技术降维。
根据公开资料显示,国内厂商中华海清科(CMP设备)、盛美上海(电镀)、芯源微(涂胶显影、临时键合与解键合)、中微公司(TSV深硅刻蚀)、拓荆科技(混合键合设备)、上海微电子(光K设备)、芯碁微装(直写光刻设备)是设备领域主要布局厂商。后道工艺布局厂商包括文一科技、耐科装备、新益昌(固晶机)、光力科技(减薄机)、德龙激光(SIP封装)、奥特维(半自动划片机)、长川科技、华峰测控、三超新材等。
CMP设备:化学机械研磨/化学机械抛光(CMP)是目前公认的纳米级全局平坦化精密加工技术。在先进封装领域,硅通孔(TSV)技术、扇出(FanOut)技术、2.5D转接板(interposer)、3DIC等都需要使用CMP设备。全球CMP设备厂商中,美国厂商应用材料占据约70%的市场份额。国内CMP设备的主要供应商为华海清科、北京烁科精微电子装备有限公司和中电45所。
清洗设备:市场竞争激烈,全球半导体清洗设备市场集中度高,主要集中在少数几家拥有核心技术的龙头企业手中。中国厂商起步相对较晚,市占率较低,仅盛美上海占全球半导体清洗设备市占率 7%,排名第五,清洗设备国产替代空间仍然广阔。
刻蚀设备:刻蚀是决定集成电路特征尺寸的核心技术之一。在半导体制造中,刻蚀设备的主要功能是将电路图案精确地刻在硅片上,形成所需的电路结构。全球刻蚀机市场份额中,拉姆研究占比46.7%,东京电子占比26.6%,应用材料占比16.7%。国内两家刻蚀机头部厂商为中微公司和北方华创。
键合设备:键合方式是决定芯片封装性能的关键工艺,混合键合是半导体先进封装的核心技术趋势,预计未来 10μm 凸点间距以下的高集成度封装将全面转向混合键合 技术,混合键合设备有望进一步成为市场主流。国产键合设备供应商主要有拓荆科技、华卓精科和芯源微等。
封测
全球布局先进封装技术的厂商主要包括IDM类厂商、代工厂商以及委外封测厂商三大类。
IDM(垂直一体化)类厂商:如英特尔和三星,能够提供芯片设计、制造和封测一站式服务。英特尔拥有EMIB 2.5D、Foveros 3D、EMIB 3.5D、Foveros Direct 3D等多种先进封装技术;三星在先进封装领域有深厚的技术积累,如2.5DRDL(再分布层)技术。
代工厂商(Foundry)和委外封测厂商(SAT)基于不同的技术路线,如2.5D、3D封装,并结合自研技术来开发先进的封装解决方案。
代工厂商(Foundry):龙头代工厂及其解决方案当属台积电(InFO,集成扇出)、日月光(FOCoS,芯片后装的基板上扇出芯片)、安靠科技(S-SWIFT,高密度扇出线)等。
委外封测厂商(OSAT):CINNO IC Research显示,在全球半导体产业链的版图上,封装测试(OSAT)作为连接芯片设计与终端应用的关键环节,中国大陆厂商首次占据Top10中的四席—长电科技、通富微电、华天科技、智路封测集体入围。
长电科技以23.6%的同比增速跃居第三,通富微电排名第四,华天科技排名第五。智路资本(WiseRoad)在2020年8月份收购了新加坡半导体封测企业联合科技(UTAC),2021年1月份收购了力成科技在新加坡的封测企业,2022年收购了日月光位于大陆的四家封测工厂,分别是苏州、昆山、威海、上海的的工厂,以上5家厂商合并称之为智路封测。此外,盛合晶微、甬矽电子、晶方科技等强劲实力厂商也在该领域深度布局。
受下游AI等领域旺盛需求拉动,移动和消费类、电信和基础设施以及终端市场需求的强劲增长,先进封装市场快速增长,产业链各细分环节有望迎来国产替代广阔机遇。



 VIP复盘网
VIP复盘网
