一论玻璃基封装载板:如何看待玻璃基封装载板的前景和壁垒?
1. 核心观点
玻璃基封装载板为何可作为下一代载板?
为适应封装发展需求,IC载板经历了金属基板、陶瓷基板、有机基板等多次演进,基本按照15年为一个更换周期。据英特尔估计,使用有机材料在硅基封装上缩放晶体管,很有可能在未来几年撞到技术的极限,寻求下一代封装基板成了必然选择。与主流有机基板相比,玻璃在平坦度、热稳定性和机械稳定性方面都有更好的表现。在2.5D/3D封装领域,相对TSV,玻璃材料没有自由移动的电荷,介电性能优良,CTE与硅接近,以玻璃替代硅材料的TGV技术可避免TSV所产生的问题。同时,TGV技术无需制作绝缘层,降低了工艺复杂度和加工成本。
玻璃基封装载板的技术壁垒体现在何处?
玻璃载板壁垒主要体现在成孔、沉铜、重布线层等。1)成形高品质通孔:玻璃通孔的成形工艺需要满足低成本、高精度、小尺寸、细间距、侧壁光滑、垂直度好等要求。当前,激光诱导刻蚀法具有低成本、一致性好等优势,应用前景较好,成为TGV厂商主要探索方向;2)高质量填充通孔:高质量填充通孔需解决:①成本和效率:与TSV不同,TGV的孔径相对较大,且多为通孔,这会导致电镀的时间和成本将增加;②玻璃与常用金属的黏附性:玻璃表面平滑,容易造成玻璃衬底与金属层间的分层,引致金属层卷曲,甚至脱落等;3)重布线层技术:玻璃基板上RDL难点在于:①玻璃表面光滑,对金属铜粘附力较弱,容易产生金属层卷曲、脱落等;②为适应更高的互联密度等,需要更窄线宽线距等。
风险提示:产业化进度不及预期;地缘政治风险加剧;国际巨头打压国内企业;出现其他替代封装材料。
2. 相关图表
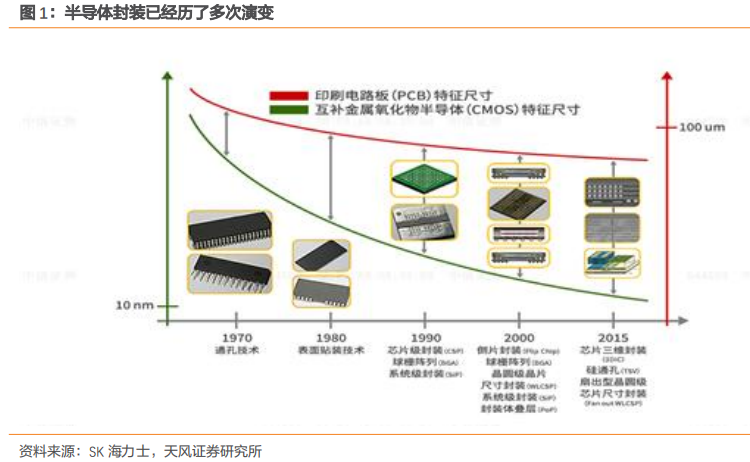
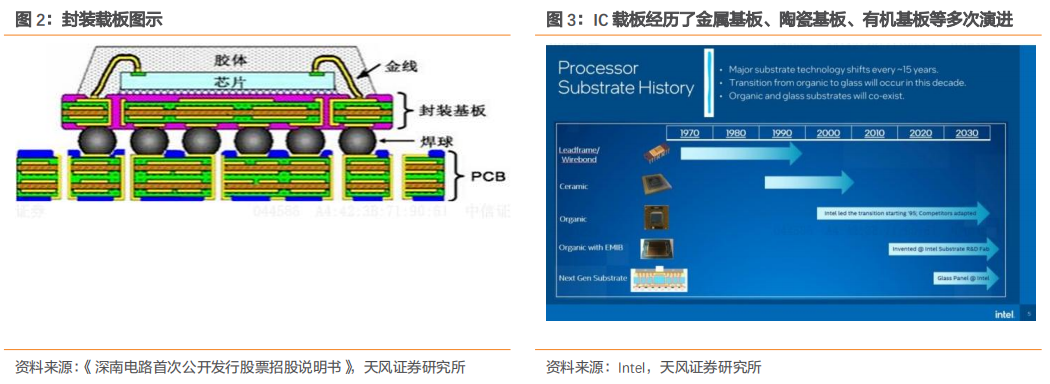


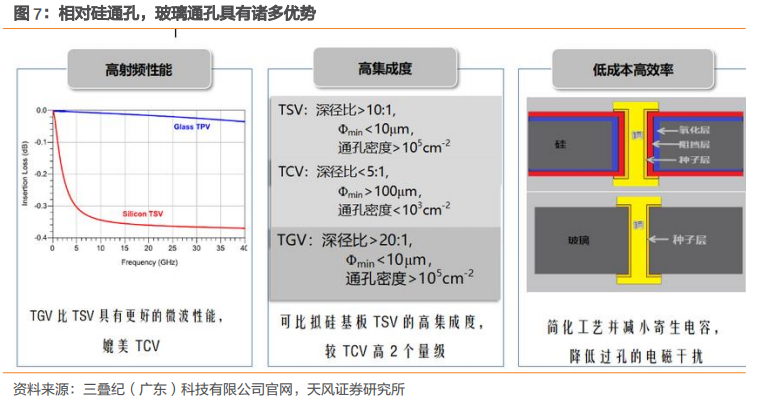


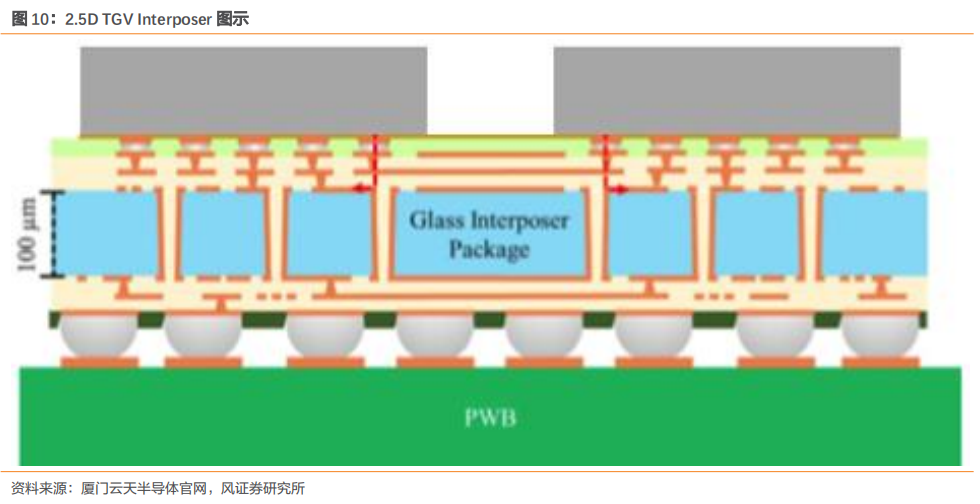


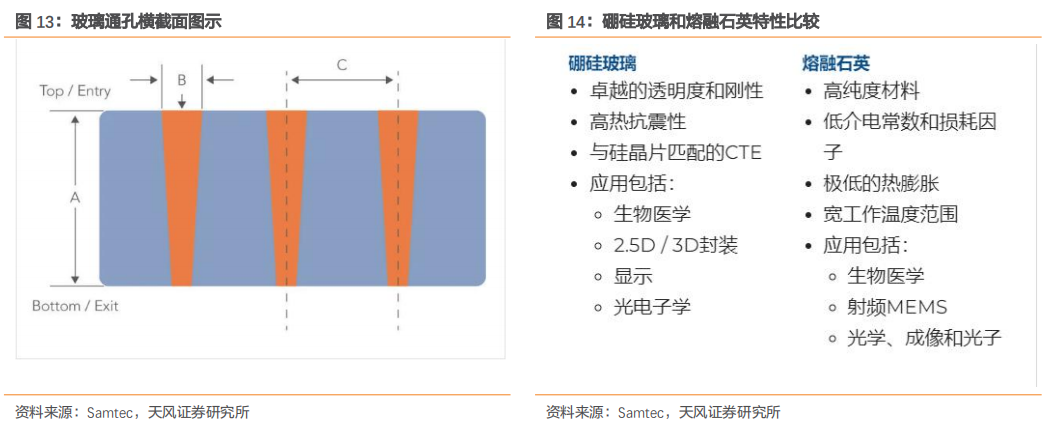
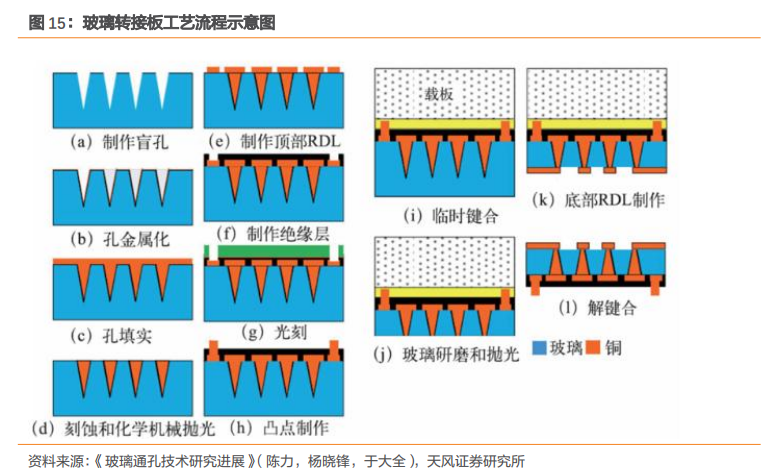
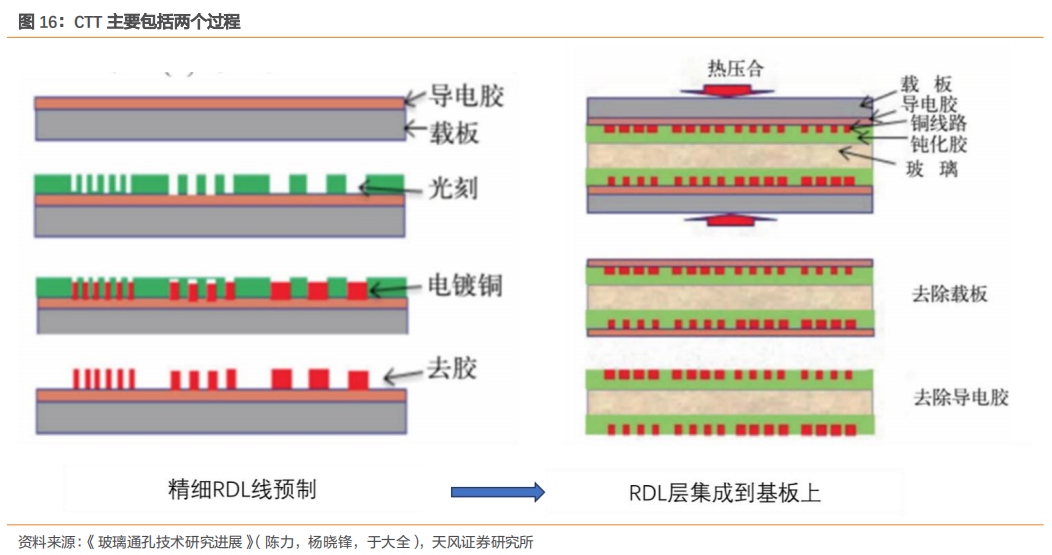





 VIP复盘网
VIP复盘网
