
当摩尔定律逼近物理极限,晶体管尺寸的微缩不再是芯片性能提升的唯一路径,先进封装技术正从产业链的“配角”一跃成为决定AI算力上限的“主角”。限制AI硬件供应的不只有芯片产能,更有CoWoS产能。据Yole Group数据,2025年全球先进封装市场规模约531亿美元,预计到2030年有望达794亿美元,年复合增长率约8.4%。
如今,全球半导体产业迎来了一场前所未有的先进封装大战:产能扩张速度创历史新高,技术路线竞争白热化,上游材料供应持续紧张,下游AI与汽车电子需求呈指数级增长。这场战争不仅关乎芯片厂商的市场份额,更成为大国科技竞争的新焦点。
 01
01如今,制约顶级AI芯片量产的核心瓶颈已经不再是先进制程的晶圆制造能力,而是先进封装环节的产能与技术供给。全球头部厂商纷纷砸下重金,掀起了一场扩产狂潮。
台积电作为全球先进封装领域的绝对霸主,其CoWoS产能占据全球85%以上的市场份额,且仍在以前所未有的速度扩产。公司计划布局7座先进封装工厂,全面部署CoWoS、WMCM及SoIC三大核心封装技术。由于高性能计算(HPC)领域的AI芯片需求远超其他细分市场,台积电的大部分封装产能将优先服务于AI算力基础设施建设。根据产能规划,到2027年,台积电先进封装年产能将从当前的130万片晶圆提升至200万片,增幅约53.85%。为快速填补市场缺口,台积电采取“新建 改造”双轨策略:一方面加速建设全新封装设施,另一方面将部分老旧8英寸晶圆厂改造为先进封装产线。相比新建工厂,改造现有厂房可大幅缩短设备调试周期。同时,台积电正积极推进美国亚利桑那州的先进封装布局,两座封装工厂计划于2030年投入量产,届时将填补美国本土芯片制造在封装环节的空白。
当日月光宣布其LEAP(先进封装及测试)业务营收从2025年的16亿美元翻倍至2026年的32亿美元时,市场意识到,OSAT(委外封测代工)已成为先进封装产能扩张的“第二波动能”。作为台积电CoWoS产能外溢的主要承接方,日月光的先进封测订单已处于爆满状态。公司斥资新台币178亿元(约合人民币38.3亿元)兴建楠梓科技第三园区,这是其近五年在中国台湾地区的最大手笔投资。该园区将建设智能运筹中心与先进制程测试大楼两栋建筑,地上8层、地下1层,预计2026年动工、2028年第二季完工。此外,日月光还计划在中国台湾省高雄仁武基地投入逾新台币1083亿元,一期工程预计2027年4月投运,二期工程将于同年10月跟进。最近,日月光投控代子公司日月光半导体公告称,经双方议价,以总价新台币148.5亿元(未税,约合人民币32亿元),向面板大厂群创光电取得位于台南市新市区新科段的南科Fab 5厂房及相关附属设施,以快速补齐先进封装产能缺口。
英特尔位于马来西亚的先进封装基地及封装测试产线将于2026年下半年正式投产。2025年底,英特尔马来西亚“塘鹅计划”先进封装基地已进入建设收尾阶段,整体完工率达99%,英特尔还追加2亿美元投资用于基地最终落成。该基地将承接芯片晶圆分选、预处理等工序,同时支持EMIB和Foveros两种先进封装工艺,可更快响应客户的产能与技术需求。与此同时,英特尔正联合长期合作的封测代工厂安靠科技,持续扩大EMIB技术产能,该技术已在安靠科技韩国松岛K5工厂落地。
半导体OSAT领军企业安靠(Amkor)宣布,计划将2026年资本支出预算提高至25亿-30亿美元,优先扩大韩国和中国台湾地区的先进封装产能。为满足客户对美国本土制造及供应链多元化的需求,安靠正借助《芯片与科学法案》补贴及客户资金,将资本支出推至历史新高。其中,约65%-70%的投资将用于全球生产设施建设,包括预计2027年中期竣工的亚利桑那州新工厂一期工程,以及越南、韩国和中国台湾地区的生产线扩建;剩余30%-35%将用于购置先进的2.5D和HDFO封装及测试设备,相关投资额预计同比增长40%。
三星电子计划在越南北部新建一座总投资额40亿美元的芯片封装工厂,进一步强化其在越南的战略布局,项目将分阶段推进,首期投资20亿美元。韩国存储巨头SK海力士则宣布,将在韩国忠清北道清州投资约19万亿韩元(约合人民币900亿元)建设新的芯片封装工厂,重点服务AI相关存储产品。新工厂将成为清州园区的重要组成部分,主要承担HBM及其他AI存储产品的先进封装任务。项目建成后,SK海力士将形成利川、清州、美国西拉法叶三大先进封装基地,进一步强化从晶圆制造到封装测试的垂直整合能力。
中国本土企业:加速追赶高端封装赛道
国内封测龙头企业也正抢抓行业机遇,加速向高端先进封装领域突破。
2026 年 1 月,通富微电发布定增公告,拟募集资金投向存储芯片、汽车等新兴应用、晶圆级、高性能计算及通信四大封测领域,同时安排 12.3 亿元用于补充流动资金及偿还银行贷款。具体来看,公司计划投入 8.88 亿元提升存储芯片封测产能,其中拟使用募集资金 8 亿元;投入 11.00 亿元布局汽车等新兴应用领域封测产能,拟使用募资 10.55 亿元,项目建设期 3 年,建成后将新增相关产能 5.04 亿块;投入 7.43 亿元建设晶圆级封测产能提升项目,将新增晶圆级封测产能 31.20 万片,同时提升厂区高可靠性车载品封测产能 15.73 亿块;投入 7.24 亿元建设高性能计算及通信领域封测产能提升项目,建成后年新增相关封测产能 4.80 亿块。
盛合晶微已完成科创板过会,募资总额高达50.28亿元,创今年以来A股新股募资之最。募资中48亿元将用来扩产2.5D/3D封装产能,资金投向三维多芯片集成封装项目(40亿元)和超高密度互联三维多芯片集成封装项目(8亿元)。
中芯国际近期全资设立上海芯三维半导体有限公司,注册资本达4.32亿美元,正式发力先进封装领域。此前,中芯国际曾与封测龙头长电科技合资成立中芯长电(盛合晶微前身),后续退出相关股份,专注于前段晶圆代工业务。随着产业趋势变化,中芯国际于今年1月底联合上下游企业开展产业链协同合作,在上海成立先进封装研究院。此番布局将补齐中芯国际在后段封装环节的短板,实现从制造到封装的垂直整合,进一步提升产品附加值与客户黏性。
 02
02产能军备竞赛的背后,是更为白热化的技术路线博弈。2025-2026年,先进封装产业正加速从2.5D向3D演进,混合键合、玻璃中介层、面板级封装等前沿技术,成为各大厂商争夺的焦点。
CoWoS:当前的绝对主流
当前AI芯片领域已形成HBM CoWoS的技术绑定关系。英伟达H100/H200/GB200、AMD MI300系列、博通AI ASIC等主流产品均采用台积电CoWoS封装。英伟达已预订台积电2026年80-85万片晶圆产能,占据超50%份额。
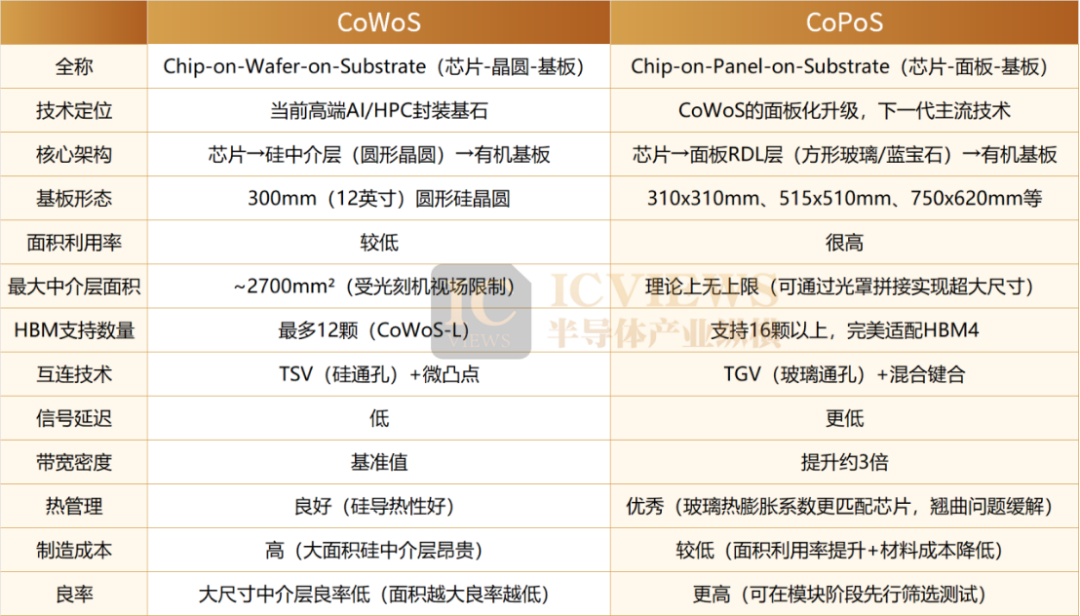
技术演进上,CoWoS正向CoPoS升级。CoPoS(Chip-on-Panel-on-Substrate)是台积电(TSMC)推出的新一代先进封装技术,被定位为CoWoS的继任者。该技术的核心是“化圆为方”,采用玻璃或蓝宝石方形载具作为中介层,以矩形面板基板(如310x310mm、750x620mm)替代传统的圆形硅中介层,旨在提升封装面积利用率、生产灵活性与可扩展性,并降低成本。台积电CoPoS(基于基板的面板级芯片封装)中试生产线已于2月启动设备交付,整条产线预计6月全面建成。量产预计于2028年底至2029年上半年实现,量产据点包括嘉义AP7厂与美国亚利桑那州厂,英伟达(NVIDIA)预计将成为首发客户。
混合键合:3D封装的终极技术
如果说CoWoS是2.5D时代的王者,那么混合键合(Hybrid Bonding)则被视为3D封装的终极技术。它能将芯片间的互连间距缩小到微米级甚至亚微米级,实现铜对铜的直接原子级贴合,从而大幅提升连接密度和带宽,降低功耗。
在HBM高带宽内存领域,混合键合已从“技术选项”变为“生存必需”。三星、美光、SK海力士三大存储巨头明确宣布:HBM5 20Hi(20层堆叠),必须采用混合键合技术。东兴证券指出,混合键合技术正从先进选项转变为AI时代的核心基础设施。在存储领域,HBM5为实现20hi超高堆叠采用此项“无凸块”技术以突破物理极限。行业已进入高速落地期:台积电等大厂提前扩产,HBM4/5与高端AI芯片将率先规模应用,相关设备需求预计在2030年前实现数倍增长,标志着该技术已成为驱动下一代算力的确定方向。
玻璃中介层:解决翘曲问题的关键
随着AI芯片尺寸不断增大,传统硅中介层的翘曲问题日益严重,玻璃基板凭借与硅匹配的热膨胀系数、极低介电损耗和超高布线密度,被视为解决这一问题的最佳方案。
2026 年 CES 上,英特尔发布了业界首款采用玻璃核心基板大规模量产的 Xeon 6 处理器;苹果公司也正深化自研 AI 硬件布局,启动先进玻璃基板测试,用于内部代号为 “Baltra” 的 AI 服务器芯片。为强化供应链掌控力,苹果采取 “孤岛式” 封闭研发策略,已直接向三星电机评估采购 T-glass 玻璃基板,而三星电机此前已向博通供应玻璃基板样品,此次与苹果的合作,标志着其在玻璃基板这一新兴业务领域的快速拓展。
目前,玻璃中介层技术正经历从技术验证向早期量产的关键转折,台积电 CoPoS 中试生产线的长远目标,正是用玻璃基板全面取代硅中介层。但玻璃基板并非完美无缺:它解决了翘曲问题,却引入了脆性缺陷 —— 边缘轻微磕碰就会产生微裂纹,这类缺陷在早期难以检测,往往到最终测试阶段才会发现整批产品报废,造成巨大的经济损失。
 03
03先进封装之战的本质,是算力交付能力的战争。当晶体管微缩逼近物理极限,当AI模型参数突破万亿级,芯片性能的提升已越来越依赖垂直集成与异构封装。2nm制程的晶体管密度固然重要,但若无先进封装技术的支撑,AI芯片的算力潜力将无法充分释放。
2026年将成为产业分水岭,在这场大战中,产能扩张的速度、技术迭代的精度、供应链整合的深度,将共同决定半导体产业下一阶段的权力分布。而对于中国大陆厂商而言,台积电高端封装产能的持续紧缺,叠加半导体产业链国产化的大趋势,或许是切入全球高端封装供应链的最后战略机遇。



 VIP复盘网
VIP复盘网
