2026年1月,名古屋大学低温等离子体科学研究中心肖新安教授和堀胜教授领导的研究团队与东京电子宫城株式会社合作,宣布他们已阐明了使用冷却晶片和氟化氢(HF)等离子体的反应离子刻蚀(RIE)工艺的机理。与传统工艺相比,二氧化硅( SiO2)薄膜的刻蚀速度提高了五倍。此外,使用HF作为刻蚀气体也降低了对环境的影响。
在制造结构精细复杂的器件时,例如 GAA(环栅)晶体管和 3D NAND 闪存,传统 RIE 工艺的蚀刻速率会显著降低。为了解决这个问题,我们提出了一种采用 HF 等离子体并冷却晶圆的新工艺。
当衬底温度保持在较低水平,例如-60℃时,刻蚀气体HF和反应产物水(H2O )会吸附在SiO2表面。研究发现, H2O起到催化剂的作用,将SiO2的刻蚀活化能降低到几乎为零。
此外,增加离子辐照能量(偏置电压)会增加H2O的量,H2O会吸附到表面并吸引HF,从而加速“自催化循环”。这种“离子增强表面自催化反应”显著加速了刻蚀反应,与传统技术相比,能够实现超快、高通量的刻蚀。
该研究小组表示:“我们已经证明,与传统的室温或低离子能量条件相比, 新工艺可将SiO2薄膜的蚀刻通量提高约100倍。 ”

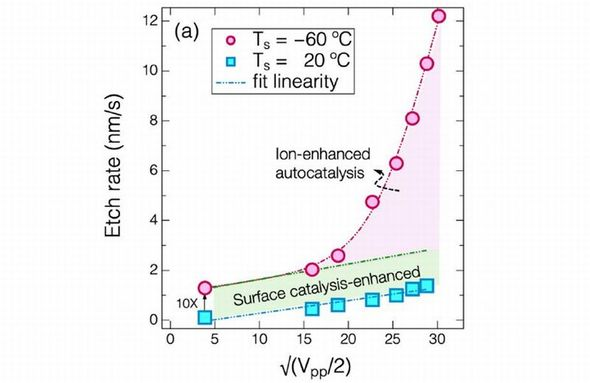
(



 VIP复盘网
VIP复盘网
